


【器件和系統封裝科技與應用】
編輯推薦
適讀人群:微電子、晶片、功率電晶體設計、製造、封裝、應用和研發人員
本書是“電晶體與集成電路關鍵技術叢書”的一本,聚焦當前電晶體、集成電路產業卡脖子科技的重點課題。
原書作者Tummala是美國佐治亞理工學院傑出教授和終身名譽教授,國際著名工業技術專家、科技先驅和教育家,曾是IBM公司先進系統封裝科技實驗室主任,現任佐治亞理工學院微系統封裝研究中心主任。
本書是Tummala教授在晶片封裝科技方面的*新力作!
內容簡介
全書分為封裝基本原理和技術應用兩大部分,共有22章。 分別論述熱機械可靠性,微米與納米級封裝,陶瓷、有機資料、玻璃和矽封裝基板,射頻和毫米波封裝,MEMS和感測器封裝,PCB封裝和板級組裝; 封裝技術在汽車電子、生物電子、通信、電腦和智能手機等領域的應用。 本書分兩部分系統性地介紹了器件與封裝的基本原理和技術應用。 隨著摩爾定律走向終結,本書提出了高密集組裝小型IC形成較大的異質和異構封裝。 與摩爾定律中的密集組裝*高數量的電晶體來均衡效能和成本的做法相反,摩爾有關封裝的定律可被認為是在2D、2.5D和3D封裝結構裏在較小的器件裏互連*小的電晶體,實現*高的效能和*低的成本。
本書從科技和應用兩個層面對每個科技概念進行定義,並以系統的管道介紹關鍵的術語,輔以流程圖和圖表等形式詳細介紹每個科技工藝。 本書的*大亮點在於每個專題章節包括基本方程、作業題和未來趨勢及推薦閱讀文獻。
本書可作為科研工程技術人員、高校教師科研參攷用書,以及大學生和研究生學習用書。
作者簡介
Rao R.Tummala教授是美國佐治亞理工學院的傑出教授和終身名譽教授,他是著名的工業技術專家、科技先驅和教育家。
在加入佐治亞理工學院之前,他是IBM研究員和IBM公司先進系統封裝科技實驗室主任。 他在20世紀70年代開創了等離子顯示器等重大科技; 並首先在LTCC(低溫共燒陶瓷)、HTCC(高溫共燒陶瓷)和薄膜RDL(再分佈層)的基礎上,開創了前三代100個晶片的MCM(多晶片組件)封裝集成,引入了現在服務器、大型機和超級電腦用2.5D封裝背後*初的MCM概念。
作為一名教育家,Tummala教授在佐治亞理工學院建立由NSF(美國國家科學基金會)資助的*大學術中心——微系統封裝研究中心方面發揮了重要作用,他擔任該中心的主任。 他率先提出了與美國、歐洲、日本、韓國、印度、中國的公司進行研究、教育以及產業合作的想法。 該中心已經培養了1200多名博士和碩士封裝工程師,為整個電子行業提供服務。
Tummala教授發表了850篇科技論文,發明的科技獲得了110多項專利。 他是第一本也是*暢銷的微電子封裝參考書
Microelectronics Packaging Handbook的作者,該書是該領域的權威性著作; 第一本大學生教材Fundamentals of Microsystems Packaging的作者; 以及引入SOP概念的Introduction to System-on-Package一書的作者。 Tummala教授曾獲得50多個行業、學術和專業協會獎項。 他先後成為NAE會員、IEEE會士、IEEE EPS和IMAPS的前任主席。
譯者介紹:
本書翻譯以中國電子科技集團有限公司所屬相關研究所的首席科學家、首席專家團隊為覈心,聯合東南大學等高校相關領域的教授、學者、專家和工程師共同完成。
目錄
序
譯者的話
關於編者
致謝
第1章器件與系統封裝科技簡介
1.1封裝的定義和作用
1.1.1封裝的定義
1.1.2封裝的重要性
1.1.3每個IC和器件都必須進行封裝
1.1.4封裝制約著電腦的效能
1.1.5封裝限制了消費電子的小型化
1.1.6封裝影響著電子產品的可靠性
1.1.7封裝制約了電子產品的成本
1.1.8幾乎一切都需要電子封裝工藝
1.2從封裝工藝的角度分析封裝的電子系統
1.2.1封裝的基本原理
1.2.2系統封裝涵蓋電力、結構和資料科技
1.2.3術語
1.3器件與摩爾定律
1.3.1片上互連
1.3.2互連資料
1.3.3片上互連的電阻和電容延遲
1.3.4器件等比例縮小的未來
1.4電子技術浪潮:微電子學、射頻/無線電、光學、微機電系統和
量子器件
1.4.1微電子學:第一波科技浪潮
1.4.2射頻/無線電:第二波科技浪潮
1.4.3光子學:第三波科技浪潮
1.4.4微機電系統:第四波科技浪潮
1.4.5量子器件與計算:第五波科技浪潮
1.5封裝與封裝摩爾定律
1.5.1三個封裝技術時代
1.5.2摩爾定律時代或SOC時代(1960—2010)
1.5.3封裝摩爾定律時代(2010—2025)
1.5.4系統時代摩爾定律(2025—)
1.6電子系統科技的趨勢
1.6.1覈心封裝技術
1.6.2封裝技術及其發展趨勢
1.7未來展望
1.7.1新興計算系統
1.7.2新興3D系統封裝
1.8本書構架
1.9作業題
1.10推薦閱讀文獻
第2章訊號、電源和電磁干擾的電力設計基礎
2.1電子封裝設計及其作用
2.2封裝的電力構成
2.2.1封裝電設計基礎
2.2.2術語
2.3訊號佈線
2.3.1器件及互連
2.3.2基爾霍夫定律與傳輸時延
2.3.3互連電路的傳輸線特性
2.3.4特性阻抗
2.3.5封裝互連常用的典型傳輸線結構
2.3.6傳輸線損耗
2.3.7串擾
2.4電源分配
2.4.1電源雜訊
2.4.2電感效應
2.4.3有效電感
2.4.4封裝設計對電感的影響
2.4.5去耦電容器
2.5電磁干擾
2.6總結和未來發展趨勢
2.7作業題
2.8推薦閱讀文獻
第3章熱管理科技基礎
3.1熱管理的定義及必要性
3.2封裝系統熱管理架構
3.2.1傳熱學基礎
3.2.2術語
3.3晶片級熱管理科技
3.3.1熱介面資料
3.3.2散熱片
3.3.3熱通孔
3.4模塊級熱管理科技
3.4.1熱沉
3.4.2熱管與均熱板
3.4.3閉環液冷
3.4.4冷板
3.4.5浸沒冷卻
3.4.6射流衝擊冷卻
3.4.7噴淋冷卻
3.5系統級熱管理科技
3.5.1風冷
3.5.2混合冷卻
3.5.3浸沒冷卻
3.6電動汽車的動力和冷卻科技
3.7總結和未來發展趨勢
3.8作業題
3.9推薦閱讀文獻
第4章熱-機械可靠性基礎
4.1什麼是熱-機械可靠性
4.2封裝失效和失效機理剖析
4.2.1熱-機械可靠性基本原理
4.2.2熱-機械建模
4.2.3術語
4.3熱-機械引起的失效類型及其可靠性設計準則
4.3.1疲勞失效
4.3.2脆性斷裂
4.3.3蠕變引起的失效
4.3.4分層引起的失效
4.3.5塑性變形失效
4.3.6翹曲引起的失效
4.4總結和未來發展趨勢
4.5作業題
4.6推薦閱讀文獻
第5章微米與納米級封裝資料基礎
5.1資料在封裝中的作用是什麼
5.2具有各種資料的封裝剖析
5.2.1封裝資料基礎
5.2.2術語
5.3封裝資料、工藝和特性
5.3.1封裝基板資料、工藝和特性
5.3.2互連和組裝資料、工藝和特性
5.3.3無源元件資料、工藝和特性
5.3.4熱和熱介面資料、工藝和特性
5.4總結和未來發展趨勢
5.5作業題
5.6推薦閱讀文獻
第6章陶瓷、有機資料、玻璃和矽封裝基板基礎
6.1什麼是封裝基板,為什麼使用封裝基板
6.2三種封裝基板剖析:陶瓷、有機資料和矽基板
6.2.1封裝基板基礎
6.2.2術語
6.3封裝基板科技
6.3.1歷史發展趨勢
6.4厚膜基板
6.4.1陶瓷基板
6.5薄膜基板
6.5.1有機資料基板
6.5.2玻璃基板
6.6採用電晶體封裝工藝加工的超薄膜基板
6.6.1矽基板
6.7總結和未來發展趨勢
6.8作業題
6.9推薦閱讀文獻
第7章無源元件與有源器件集成基礎
7.1什麼是無源元件,為什麼用無源元件
7.2無源元件分析
7.2.1無源元件的基本原理
7.2.2術語
7.3無源元件科技
7.3.1分立無源元件
7.3.2集成無源元件
7.3.3嵌入式分立無源元件
7.3.4嵌入式薄膜無源元件
7.4無源和有源功能模組
7.4.1射頻模塊
7.4.2功率模組
7.4.3電壓調節器功率模組
7.5總結和未來發展趨勢
7.6作業題
7.7推薦閱讀文獻
第8章晶片到封裝互連和組裝基礎
8.1什麼是晶片到封裝互連和組裝,以及為什麼要做
8.2互連和組裝的剖析
8.2.1晶片級互連和組裝的類型
8.2.2互連和組裝基礎
8.2.3組裝與鍵合基礎
8.2.4術語
8.3互連和組裝科技
8.3.1演進
8.3.2引線鍵合
8.3.3載帶自動焊
8.3.4倒裝焊互連和組裝科技
8.3.5帶焊料帽的銅柱科技
8.3.6SLID互連和組裝科技
8.4互連和組裝的未來趨勢
8.5作業題
8.6推薦閱讀文獻
第9章嵌入與扇出型封裝基礎
9.1嵌入和扇出型封裝的定義及採用原因
9.1.1為什麼採用嵌入和扇出型封裝
9.2扇出型晶圓級封裝結構
9.2.1典型扇出型晶圓級封裝工藝
9.2.2扇出型晶圓級封裝技術基礎
9.2.3術語
9.3扇出型晶圓級封裝技術
9.3.1分類
9.3.2資料和工藝
9.3.3扇出型晶圓級封裝工具
9.3.4扇出晶圓級封裝技術的挑戰
9.3.5扇出型晶圓級封裝的應用
9.4在制板級封裝
9.4.1在制板級封裝的定義及採用原因
9.4.2在制板級封裝製造基礎設施的種類
9.4.3在制板級封裝的應用
9.5總結和未來發展趨勢
9.6作業題
9.7推薦閱讀文獻
第10章採用和不採用TSV的3D封裝基礎
10.1TSV-3D集成電路的概念
10.1.1採用TSV實現3D集成電路
10.2採用TSV的3D封裝剖析
10.2.1採用TSV的3D集成電路基礎
10.2.2術語
10.3採用TSV科技的3D集成電路
10.3.1TSV
10.3.2超薄集成電路
10.3.3後道RDL佈線科技
10.3.43D堆疊的晶片互連
10.3.53D堆疊集成電路的封裝
10.3.6底部填充
10.4總結和未來發展趨勢
10.5作業題
10.6推薦閱讀文獻
10.7致謝
第11章射頻和毫米波封裝的基本原理
11.1什麼是射頻,為什麼用射頻
11.1.1歷史與發展
11.1.2第一部手機是什麼時候推出的
11.2射頻系統的概述
11.2.1射頻的基本原理
11.2.2射頻名詞術語
11.3射頻技術與應用
11.3.1收發機
11.3.2發射機
11.3.3接收機
11.3.4調製方式
11.3.5天線
11.3.6射頻前端模塊中的元器件
11.3.7濾波器
11.3.8射頻資料和元器件
11.3.9射頻建模與表徵科技
11.3.10射頻的應用
11.4什麼是毫米波系統
11.5毫米波封裝剖析
11.5.1毫米波封裝的基本原理
11.6毫米波科技與應用
11.6.15G及以上
11.6.2汽車雷達
11.6.3毫米波成像
11.7總結和未來發展趨勢
11.8作業題
11.9推薦閱讀文獻
第12章光電封裝的基礎知識
12.1什麼是光電子學
12.2光電系統的剖析
12.2.1光電子學基礎
12.2.2術語
12.3光電子技術
12.3.1有源光電子器件
12.3.2無源光電子器件
12.3.3光學互連
12.4光電系統、應用和市場
12.4.1光電系統
12.4.2光電子學應用
12.4.3光電子市場
12.5總結和未來發展趨勢
12.6作業題
12.7推薦閱讀文獻
第13章MEMS原理與感測器封裝基礎
13.1什麼是MEMS
13.1.1歷史演變
13.2MEMS封裝的分析
13.2.1MEMS封裝原理
13.2.2術語
13.3MEMS與感測器器件製造技術
13.3.1光刻圖形轉移
13.3.2薄膜沉積
13.3.3幹法和濕法刻蝕
13.3.4矽的體和表面微加工
13.3.5晶圓鍵合
13.3.6雷射微加工
13.3.7工藝集成
13.4MEMS封裝技術
13.4.1MEMS封裝資料
13.4.2MEMS封裝工藝流程
13.5MEMS及其感測器的應用
13.5.1壓力感測器
13.5.2加速度計和陀螺儀
13.5.3投影顯示器
13.6總結和未來發展趨勢
13.7作業題
13.8推薦閱讀文獻
第14章包封、模塑和密封的基礎知識
14.1什麼是密封和包封,為什麼要這麼做
14.2包封和密封封裝的結構
14.2.1包封和密封的基本功能
14.2.2術語
14.3包封資料的效能
14.3.1機械效能
14.3.2熱學效能
14.3.3物理性能
14.4包封資料
14.4.1環氧樹脂和相關材料
14.4.2氰酸酯
14.4.3聚氨酯橡膠
14.4.4有機矽
14.5包封工藝
14.5.1模塑
14.5.2液體包封
14.6氣密性封裝
14.6.1密封工藝
14.7總結和未來發展趨勢
14.8作業題
14.9推薦閱讀文獻
第15章印製線路板原理
15.1什麼是印製線路板
15.2印製線路板的剖切結構
15.2.1印製線路板的基本原理
15.2.2印製線路板的類型
15.2.3印製線路板的資料等級
15.2.4單面至多層板及其應用
15.2.5印製線路板的設計要素
15.2.6術語
15.3印製線路板科技
15.3.1印製線路板資料
15.3.2印製線路板製造
15.3.3印製線路板應用
15.4總結和未來發展趨勢
15.5作業題
15.6推薦閱讀文獻
第16章板級組裝基本原理
16.1印製電路板組件的定義和作用
16.2印製電路板組件結構
16.2.1PCBA的基本原理
16.2.2術語
16.3PCBA科技
16.3.1PCB基板
16.3.2封裝基板
16.4印製電路板組裝的類型
16.4.1鍍覆通孔組裝
16.4.2表面安裝組裝
16.5組裝焊接工藝類型
16.5.1回流焊
16.5.2PTH波峰焊
16.6總結和未來發展趨勢
16.7作業題
16.8推薦閱讀文獻
16.9致謝
第17章封裝技術在未來汽車電子中的應用
17.1未來汽車電子:是什麼,為什麼
17.2未來汽車剖析
17.2.1未來汽車的基本原理
17.2.2術語
17.3未來汽車電子技術
17.3.1計算與通信
17.3.2傳感電子
17.3.3大功率電子
17.4總結和未來發展趨勢
17.5作業題
17.6推薦閱讀文獻
第18章封裝技術在生物電子中的應用
18.1什麼是生物電子學
18.1.1生物電子學的應用
18.1.2生物電子系統剖析
18.2生物電子系統封裝技術
18.2.1生物相容和生物穩定型封裝
18.2.2異構系統集成
18.3生物電子植入物舉例
18.3.1心臟起搏器和電子支架
18.3.2人工耳蝸
18.3.3視網膜假體
18.3.4神經肌肉刺激器
18.3.5腦神經記錄和刺激
18.4總結和未來發展趨勢
18.5作業題
18.6推薦閱讀文獻
第19章封裝技術在通信系統中的應用
19.1什麼是通信系統
19.2兩種通信系統剖析:有線和無線
19.2.1有線通信系統剖析
19.2.2無線通訊系統剖析
19.3通信系統科技
19.3.1歷史演變
19.3.2通信系統科技
19.3.3無線通訊系統科技
19.4總結和未來發展趨勢
19.5作業題
19.6推薦閱讀文獻
第20章封裝技術在電腦系統中的應用
20.1什麼是電腦封裝
20.2對電腦封裝的剖析
20.2.1電腦封裝基礎
20.2.2計算系統的類型
20.2.3術語
20.3電腦封裝技術
20.3.1演進歷程
20.3.2互連科技
20.3.3訊號和電源的互連設計
20.4熱科技
20.4.1熱管理
20.4.2熱-機械可靠性
20.4.3資料科技
20.5總結和未來發展趨勢
20.5.1封裝摩爾定律的起點
20.5.2封裝成本的摩爾定律
20.6作業題
20.7推薦閱讀文獻
20.8致謝
第21章封裝技術在柔性電子中的應用
21.1什麼是柔性電子,為什麼叫作柔性電子
21.1.1應用
21.2柔性電子系統的結構剖析
21.2.1柔性電子技術基礎
21.2.2術語
21.3柔性電子技術
21.3.1元器件科技
21.3.2柔性電子技術的工藝集成
21.3.3柔性基板上的元器件組裝
21.4總結和未來發展趨勢
21.5作業題
21.6推薦閱讀文獻
第22章封裝技術在智能手機中的應用
22.1什麼是智能手機
22.1.1為什麼需要智能手機
22.1.2智能手機的歷史演進
22.2智能手機剖析
22.2.1智能手機基礎
22.2.2術語
22.3智能手機封裝技術
22.3.1應用處理器封裝
22.3.2記憶體封裝
22.3.3射頻封裝
22.3.4功率封裝
22.3.5MEMS和感測器封裝
22.4智能手機中的系統封裝
22.5總結和未來發展趨勢
22.6作業題
22.7推薦閱讀文獻
書摘插畫





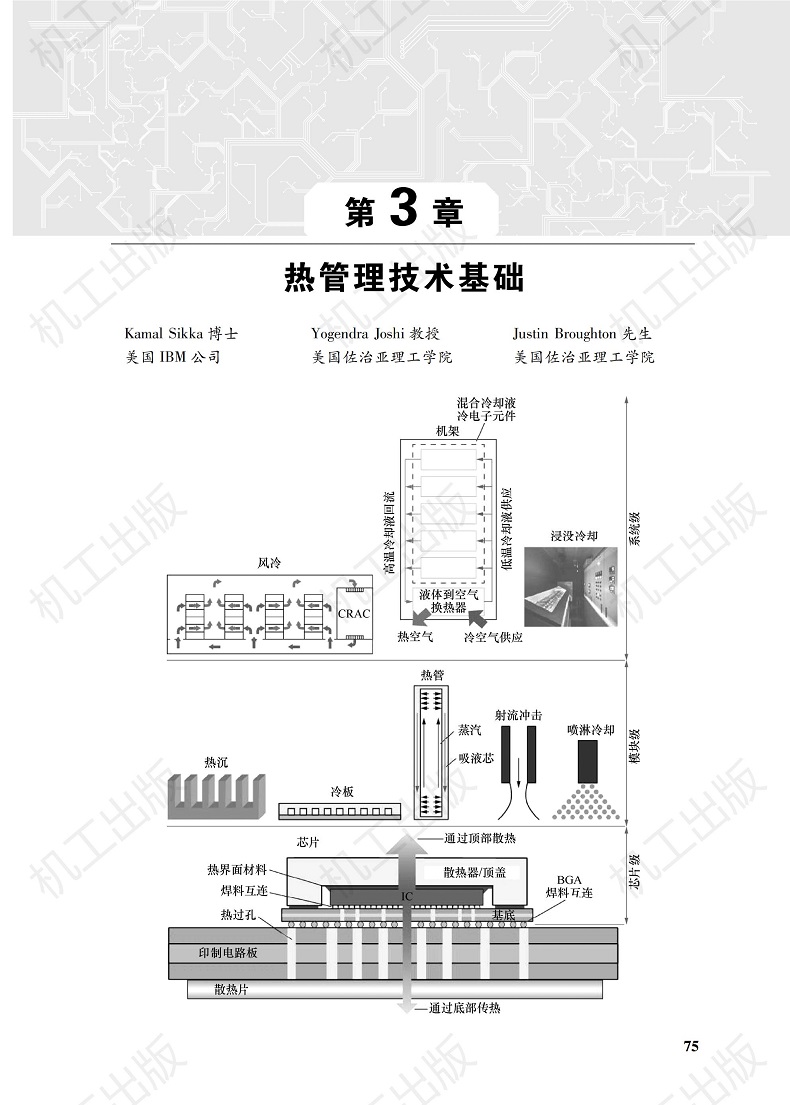

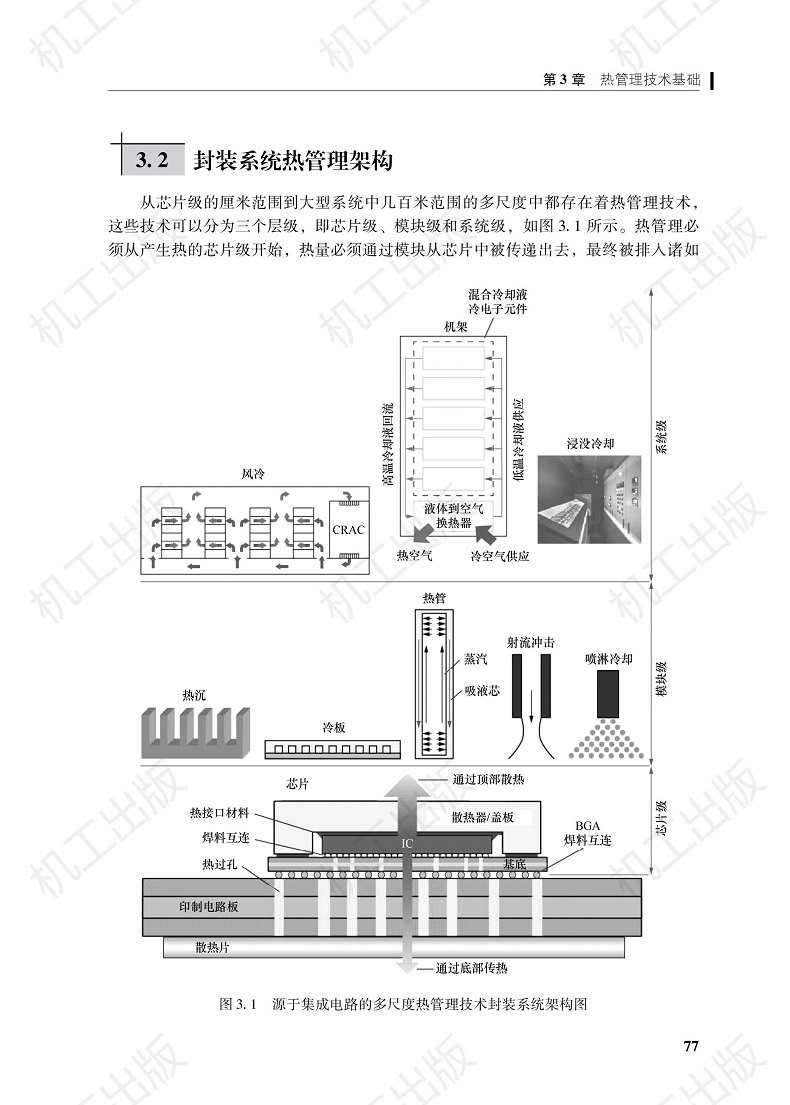
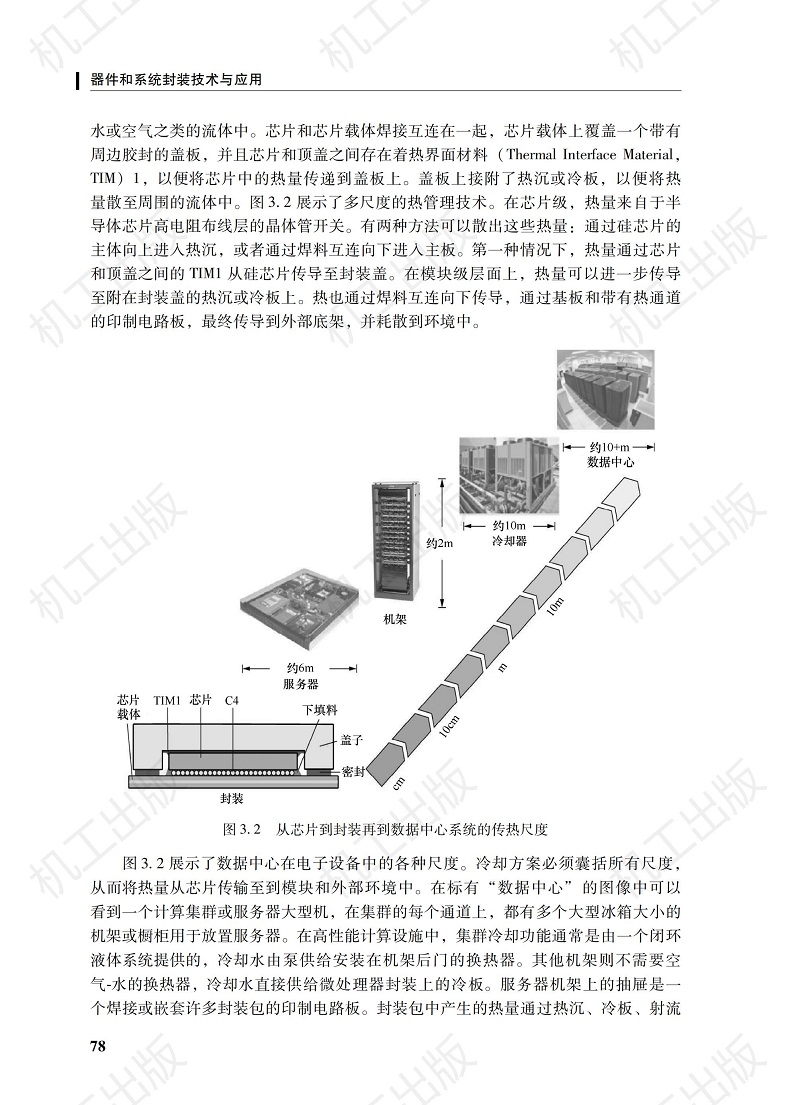

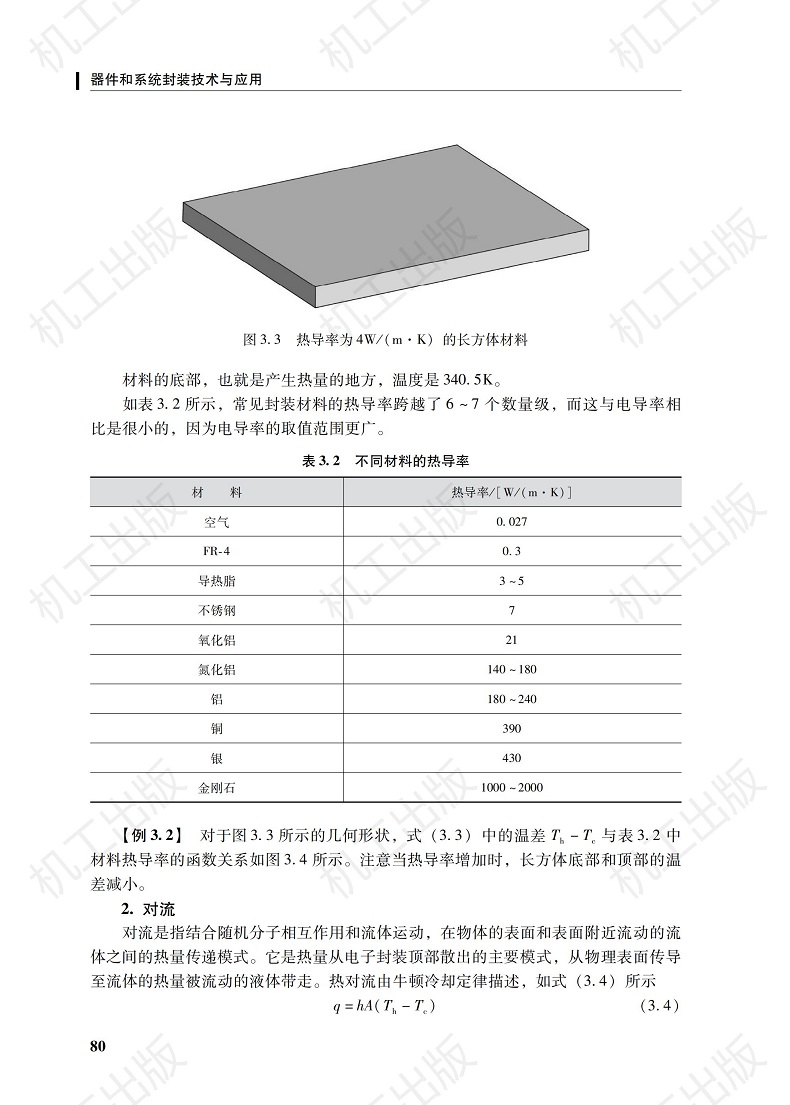
-------------------------------------------------------------------------------------

【三維微電子封裝:從架構到應用】
編輯推薦
適讀人群:適合從事集成電路晶片封裝科技的工程師、科研人員和科技人員閱讀,也可作為高等院校微電子封裝工程專業的高年級大學生、研究生以及培訓人員的教材和教學參考書。
本書堪稱電子封裝領域的百科全書,介紹了當今三維堆疊封裝技術所涉及的幾乎所有知識,是一本不可多得封裝領域優秀讀物。 本書配有百餘幅彩色圖片。
內容簡介
本書為學術界和工業界的研究生和專業人士提供了全面的參攷指南,內容涉及三維微電子封裝的基本原理、科技體系、工藝細節及其應用。 本書向讀者展示了有關該行業的技術趨勢,使讀者能深入瞭解*新的研究與開發成果,包括TSV、晶片工藝、微凸點、直接鍵合、先進資料等,同時還包括了三維微電子封裝的質量、可靠性、故障隔離,以及失效分析等內容。 書中使用了大量的圖表和精心製作的示意圖,可以幫助讀者快速理解專業科技資訊。 讀者通過本書將全面地獲得三維封裝技術以及相關的質量、可靠性、失效機理等知識。 此外,本書還對三維封裝技術尚在發展中的領域和存在的差距做了介紹,為未來的研究開發工作帶來有益的啟發。
本書適合從事集成電路晶片封裝科技的工程師、科研人員和科技人員閱讀,也可作為高等院校微電子封裝工程專業的高年級大學生、研究生以及培訓人員的教材和教學參考書。
作者簡介
李琰
李琰(Yan Li)博士是英特爾公司位於美國亞利桑那州錢德勒“組裝測試與技術開發失效分析實驗室”的高級主任研究員。 她在北京大學獲得物理學學士和碩士學位,並於2006年獲得美國西北大學材料科學與工程博士學位。 作為英特爾三維封裝技術開發專案的首席封裝失效分析工程師,李博士參與了英特爾眾多封裝相關的科技解決方案,並專注於電子封裝的質量和可靠性,對失效模式和失效機理有深入的研究,開發了用於三維封裝故障隔離和失效分析的新工具及科技。 李博士是礦物金屬和資料學會(TMS)、美國金屬學會(AMS)和電子器件失效分析協會(EDFAS)等多個國際專業學會的資深會員及撰稿人。 自2011年以來李博士擔任了TMS、測試與失效分析國際會議(ISTFA)的年會組織者。 李博士2018年進入集成電路物理與失效分析國際會議技術委員會(IPFA),她還獲得了2014年TMS EMPMD青年領袖專業發展獎。 李博士在微電子封裝領域發表了20餘篇論文及多項專利,並聯合編撰了受到業界高度認可的著作《3D Microelectronic Packaging》。
迪帕克? 戈亞爾
迪帕克? 戈亞爾(Deepak Goyal)博士現時是英特爾ATTD/ATM封裝FA和LYA實驗室的主任,畢業於紐約州立大學石溪分校並獲得材料科學與工程博士學位。 他負責為英特爾下一代微電子封裝開發新的分析工具,缺陷表徵,故障隔離,失效和資料分析科技。 協助開發了英特爾整套封裝技術,包括FCxGA,FCCSP,TSV,EMIB和Foveros等等。 他作為失效分析方面的專家,在國際電子元件與科技會議(ECTC)上教授了有關封裝FA/FI方法及失效機理的專業課程。 他曾獲得了兩項英特爾成就獎和25項部門獎。 Goyal博士已撰寫或合著了50多篇論文,並擁有11項美國專利。 他是IEEE的高級會員,曾擔任由電晶體製造技術戰略聯盟(Sematech)舉辦的封裝與互連故障分析論壇主席,以及ECTC應用可靠性委員會主席。
目錄
第1章三維微電子封裝概論
1.1導言
1.2為什麼採用三維封裝
1.2.1摩爾定律
1.2.2小型化需要三維封裝
1.2.3降低功耗提高系統性能
1.3三維微電子封裝架構
1.3.1晶片-晶片三維集成
1.3.2封裝-封裝三維集成
1.3.3三維異構集成
1.4三維微電子封裝的挑戰
1.4.1組裝工藝、良率、測試及成本的挑戰
1.4.2熱管理、封裝設計及建模的挑戰
1.4.3資料和基板的挑戰
1.4.4質量、可靠性及失效分析的挑戰
1.5小結
參考文獻
第2章三維封裝架構和組裝流程設計
2.1導言
2.2基於矽通孔(TSV)的三維架構:優勢與劣勢
2.3 TSV的製造方法及其他特性
2.4組裝工藝流程
2.5製造良率及測試的作用
2.6 TSV三維架構的挑戰
2.7小結
參考文獻
第3章矽通孔(TSV)的資料與工藝
3.1導言
3.2 TSV的資料與工藝概覽
3.3 TSV的製作與組裝
3.3.1在矽晶圓上形成孔或溝槽
3.3.2循序填充矽通孔
3.3.3平坦化和晶片减薄
3.4 TSV製作與晶片集成的工藝流程
3.4.1流程順序
3.4.2包含TSV的晶片集成
3.5小結
參考文獻
第4章TSV的微結構與力學可靠性
4.1導言
4.2微觀結構表徵及應力量測
4.2.1微觀結構表徵
4.2.2應力狀態量測
4.3 TSV相關的可靠性問題
4.3.1 TSV中的應力
4.3.2電遷移有關的效應
4.4面向原子資訊的TSV可靠性建模
4.4.1 CPFE法
4.4.2 PFC法
4.5小結
參考文獻
第5章晶體相場(PFC)模型:一種在TSV中探測原子的工具
5.1引言
5.2 PFC模型基礎
5.2.1經典密度泛函理論
5.2.2近似模型
5.2.4控制方程
5.2.5多組分多相系統的應用
5.2.6物理場耦合
5.3 TSV的PFC模型
5.3.1三角晶格
5.3.2方晶格
5.3.3基於石墨烯的TSV
5.4總結
參考文獻
第6章TSV擠出效應的原子尺度動力學
6.1導言
6.2模型設定和TSV擠出的實例
6.3不同機械載荷條件下的擠出
6.3.1剪切應變 γ yx
6.3.2法向應變 ε x和剪切應變 γ xy
6.3.3法向應變 ε y
6.3.4載荷分佈
6.4晶粒結構的影響
6.4.1晶粒分佈
6.4.2晶粒尺寸
6.4.3晶粒取向
6.5溫度的影響
6.6幾何形狀的影響
6.6.1 TSV的形狀
6.6.2側壁粗糙度
6.7 TSV擠出效應的一般觀點
6.7.1原子機制
6.7.2擠出的輪廓預測準則
6.7.3塑性流動觀點
6.8展望
參考文獻
第7章三維封裝晶片準備的原理及失效
7.1導言
7.2 TSV晶圓制造技術概述
7.3臨時晶圓鍵合
7.4晶圓解鍵合及清潔
7.5晶圓雷射劃片
7.6晶圓砂輪劃片
7.7晶圓晶片頂出
7.8晶片貼裝
7.9底部填充
7.10結論
參考文獻
第8章銅-銅(Cu-Cu)直接鍵合及三維封裝的其他鍵合科技
8.1導言
8.2基於焊料鍵合與無焊料鍵合:優點與缺點
8.3堆疊和鍵合方案、科技與應用
8.4熱壓鍵合(一種典型的擴散焊):資料基礎及微觀結構效應
8.5覆蓋層鈍化:自組裝單分子膜(SAM)和金屬
8.6表面活化鍵合(SAB)工藝
8.7 Cu/介質混合鍵合
8.7.1 Cu/SiO2混合鍵合
8.7.2 Cu/粘合劑混合鍵合
8.8另一種Cu-Cu鍵合科技:插入鍵合
8.9 Cu–Cu鍵合設備概覽及現狀
8.10小結及後續研究建議
參考文獻
第9章微米/納米銅在三維互連中的應用
9.1導言
9.1.1金屬納米顆粒鍵合綜述
9.1.2混合銅顆粒鍵合的應用動因
9.2燒結致密度建模
9.2.1算灋設計與假設
9.2.2 3D模擬結果
9.2.3小結
9.3銅漿配方及表徵
9.3.1銅漿配方和燒結曲線
9.3.2熱學和電學特性
9.3.3模擬與試驗結果的探討
9.3.4小結
9.4晶片到晶圓鍵合驗證
9.4.1實驗內容
9.4.2鍵合剪切强度
9.4.3小結
9.5總結與展望
9.5.1總結
9.5.2展望
參考文獻
第10章2.5/3D封裝鍵合科技與工藝資料基礎
10.1導言
10.2背景介紹
10.2.1三維封裝結構概述
10.2.2熱壓焊(TCB)科技的基本原理
10.2.3工藝資料基礎
10.3資料配方原理
10.3.1水溶性助焊劑
10.3.2免清洗助焊劑
10.3.3毛細底部填充
10.3.4環氧助焊劑(非流動底部填充膠或非導電膠)
10.3.5預塗環氧基資料(非導電膜及B階資料)
10.4組裝工藝設計
10.4.1簡介
10.4.2 TCB組裝工藝要素
10.4.3 TCB組裝工藝要素的設計和開發
10.5專題:綜合比較分析傳統回流焊與TCB的Sn-Ag-Cu(SAC)焊點微觀結構
10.5.1簡介
10.5.2實驗部分
10.5.3結果和討論
10.5.4結論
10.6小結與討論
參考文獻
第11章三維封裝焊料合金基礎
11.1微凸點工藝
11.2微凸點的焊料合金
11.3微凸點焊接中金屬間化合物的形成
11.4熱力學環境下微凸點的微觀結構演變
11.5微凸點的微觀結構與失效機理
11.6小結和未來的挑戰
參考文獻
第12章三維封裝互連的電遷移原理
12.1導言
12.2焊點電遷移的關鍵影響因素
12.2.1錫擴散引起的典型電遷移失效
12.2.2金屬化層溶解導致的電遷移失效
12.3三維封裝中焊點的電遷移
12.3.1微凸點中錫擴散導致的電遷移損傷
12.3.2電遷移中全金屬間化合物焊點的形成
12.3.3伴隨電遷移的熱遷移
12.4三維封裝中TSV的電遷移
12.4.1大馬士革Cu互聯的電遷移
12.4.2 TSV的電遷移失效
12.4總結
參考文獻
第13章三維集成電路封裝的散熱與熱設計基礎
13.1導言
13.2三維集成電路的熱性能參數
13.3三維集成電路的空氣冷卻
13.4射流衝擊和噴霧冷卻
13.5微通道冷卻
13.6三維集成電路架構中的熱設計注意事項
13.6.1 TSV佈局的散熱注意事項
13.6.2用於三維集成電路的熱分析工具
13.6.3效能注意事項
13.6.4用於帶液體冷卻的三維集成電路的新興無線互連
13.7集成微通道的液冷散熱
13.7.1變密度翅片對微通道熱效能的改善
13.7.2兩相冷卻
13.8未來方向
參考文獻
第14章有機基板科技中的先進資料與工藝基礎
14.1簡介
14.2基板科技的發展概述
14.3有機基板資料
14.3.1有機基板生產中使用的資料
14.3.2資料概述
14.3.3基板和PWB的芯板
14.3.4介質資料
14.3.5金屬化過孔和過孔填充資料
14.3.6阻焊資料
14.3.7表面塗覆
14.3.8小結
14.4有機基板制造技術概述
14.4.1基板原料的選擇與製備
14.4.2內層圖形成像
14.4.3積層工藝
14.4.4阻焊、表面塗覆及一級互連形成
14.5.5最終成型、測試、檢驗和出貨
參考文獻
第15章三維封裝中晶片和封裝級熱、濕-熱應力:建模與特徵選取
15.1導言
15.2熱應力及其對TSV結構的影響
15.2.1引言
15.2.2基於半解析和數值計算的TSV應力表徵方法
15.2.3熱應力的量測
15.2.4熱應力對載流子遷移率和禁區的影響
15.2.5熱應力導致的通孔擠出
15.3封裝級熱應力及翹曲控制
15.3.1引言
15.3.2多層結構中的熱應力
15.3.3翹曲機理及控制方法
15.3.4用於翹曲控制的晶片蓋帽方法
15.3.5翹曲特性的試驗測試
15.3.6基於數值模擬的翹曲控制設計優化
15.4濕-熱聯合作用下的綜合應力分析
15.4.1引言414
15.4.2濕氣擴散理論
15.4.3濕氣誘導的應變和等效應力理論
15.4.4蒸汽壓力建模
15.4.5綜合應力分析耦合方程
15.4.6案例分析
15.5小結
參考文獻
第16章堆疊封裝互連焊接的工藝與可靠性
16.1導言
16.1.1小型化和功能化趨勢
16.1.2三維封裝的變體
16.1.3應用驅動的PoP和PoPoP器件要求
16.2焊接組裝工藝
16.2.1焊料合金
16.2.2助焊劑與焊膏
16.2.3組裝方法
16.2.4檢測科技
16.2.5底部填充、保形塗覆和包封資料
16.2.6翹曲效應
16.3焊點可靠性
16.3.1環境
16.3.2底部填充、保形塗覆和包封
16.3.3可靠性研究
16.4小結及未來發展趨勢
16.4.1小結
16.4.2未來發展趨勢
參考文獻
第17章三維封裝的互連質量與可靠性
17.1導言
17.2三維封裝的質量挑戰
17.3微凸點的質量與可靠性
17.3.1類型1——Cu/Sn/Cu
17.3.2類型2-——Ni/Sn/Ni
17.3.3類型3——Cu/Sn/Ni
17.3.4類型4——Cu/Ni/Sn/Ni/Cu
17.3.5小結
17.4三維封裝的現場效能預測
17.5三維封裝的電遷移可靠性
17.5.1電遷移簡介
17.5.2鋁、銅互連的電遷移實驗研究
17.5.3倒裝晶片焊點的電遷移
17.5.4三維集成電路封裝的系統級電遷移研究
17.5.5 2.5維集成電路中的系統級薄弱環節失效
17.5.6小結
17.6三維集成電路封裝中的熱遷移
17.6.1概述
17.6.2熱遷移原理
17.6.3三維集成電路封裝中的熱遷移研究
17.6.4小結
參考文獻
第18章三維封裝的故障隔離與失效分析
18.1導言
18.2三維先進封裝的故障隔離與失效分析的挑戰
18.3無損故障隔離和失效分析科技在三維微電子封裝中的應用
18.3.1三維微電子封裝電力失效的無損故障隔離科技
18.3.2三維微電子封裝的高解析度無損成像科技
18.4面向三維微電子封裝的樣品製備及資料分析技術應用
18.4.1樣品製備技術
18.4.2資料分析科技
18.5三維封裝的失效分析策略
18.5.1理解封裝組裝過程、可靠性應力和失效率分佈
18.5.2識別缺陷的高效FI-FA流程
18.5.3深入瞭解失效機理和根本原因,提供解决路徑
18.5.4小結
參考文獻
書摘插畫





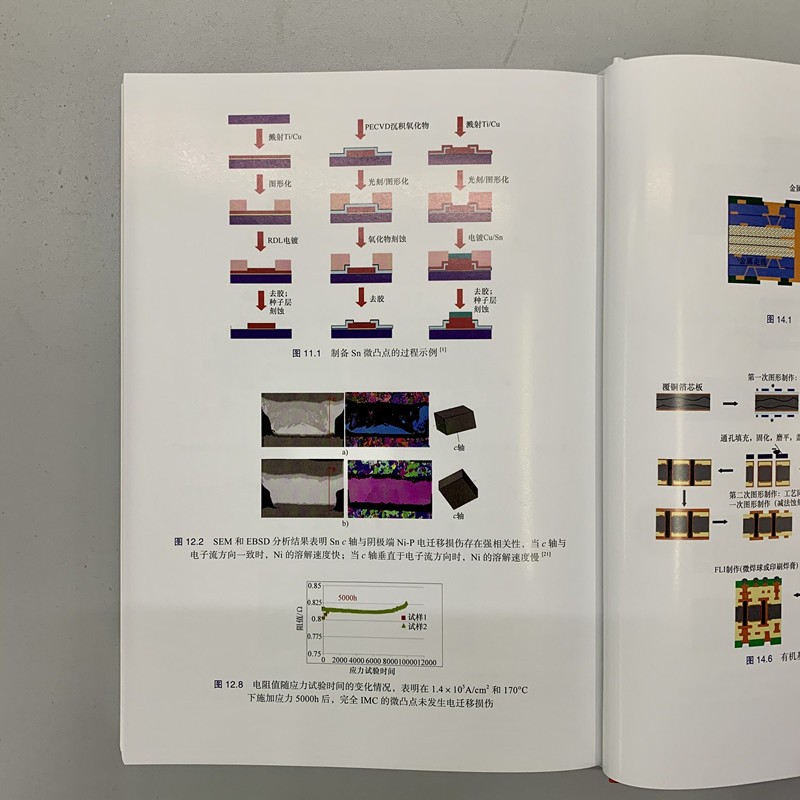










桃園楊**[0920***343] 半小時前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 臺北仲**[0960***398] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 臺北錢**[0933***427] 2分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 臺北楊**[0918***257] 4分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 高雄謝**[0918***542] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 高雄黃**[0918***183] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 高雄楊**[0960***401] 半小時前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 新竹陳**[0938***100] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 高雄柳**[0932***452] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 基隆鄭**[0968***473] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 高雄符**[0938***238] 4分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 臺中楊**[0978***318] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 嘉義黃**[0960***216] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 嘉義劉**[0933***434] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 桃園楊**[0978***437] 15分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 高雄王**[0956***102] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 桃園楊**[0920***686] 4分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 高雄周**[0986***539] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 高雄方**[0956***909] 15分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 新竹王**[0966***711] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 基隆錢**[0966***428] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 嘉義李**[0966***356] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 新北鄭**[0966***778] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 高雄楊**[0968***879] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 桃園方**[0978***423] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 新竹王**[0946***212] 25分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 新竹劉**[0946***972] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 高雄楊**[0918***349] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 臺南陳**[0938***441] 15分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 臺北方**[0933***375] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 嘉義陳**[0988***376] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 桃園李**[0951***836] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 嘉義黃**[0933***933] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 新北方**[0978***313] 5分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 新竹黃**[0986***114] 2分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 桃園方**[0998***926] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 臺北柳**[0956***114] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 新竹王**[0920***665] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 臺北謝**[0932***882] 4分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 嘉義鄭**[0986***192] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 臺北柳**[0968***668] 15分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 嘉義吳**[0988***777] 半小時前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 臺中錢**[0951***388] 25分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 基隆方**[0920***174] 20分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 新竹仲**[0988***361] 4分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 嘉義方**[0938***123] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) 嘉義吳**[0946***923] 12分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 臺北朱**[0968***362] 2分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】(單册) 桃園鄭**[0956***837] 7分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【三維微電子封裝:從架構到應用】(單册) 桃園吳**[0933***181] 11分鐘前【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册) - 【器件和系統封裝科技與應用】+【三維微電子封裝:從架構到應用】(精裝塑封兩册)
































