

【微電子引線鍵合】
編輯推薦
在集成電路晶片產業,現時三維封裝是比較火熱的科技方向,而不論對於任何封裝,引線鍵合科技(俗稱打線,或者邦定,也就是將裸晶片和封裝外殼通過金屬絲互連起來的過程)是封裝過程中的地位是蕞覈心、蕞底層也是直接關係到晶片能否正常工作的關鍵。 因為晶片尺寸越來越小(幾釐米),引脚越來多(成百上千),速度越來越快、工作溫度越來越高,這線要怎麼連,用什麼資料、用什麼設備、用什麼工藝,都在不斷提出新的挑戰,特別是現在引線的焊點都是微米級別的,容不得一絲一毫的差錯,這就是引線鍵合科技的意義。
相比晶片製造和設計,我國在封裝領域更加具有優勢,所占的全產業規模比重蕞大,而作為封裝技術的覈心環節,引線鍵合科技的研發也是我國各大研究所、院校、企業等“國家隊”重點探索的方向,本書的原書是國際公認的有關引線鍵合蕞全面和權威的著作, 其翻譯就是來自我國的封裝“國家隊”中電科集團第29研究所,本書的引進對於國內的封裝領域具有極高的指導意義。
內容簡介
《微電子引線鍵合(原書第3版)》翻譯自喬治哈曼(George Harman)教授的著作Wire Bonding in Microelectronics(3rd Edition),系統總結了過去70年引線鍵合科技的發展脈絡和*新成果,並對未來的發展趨勢做出了展望。 主要內容包括:超聲鍵合系統與科技、鍵合引線的冶金學特性、引線鍵合測試方法、引線鍵合金屬介面反應、鍵合焊盤鍍層及鍵合可靠性、清洗、引線鍵合中的力學問題等,*後討論了先進引線鍵合科技、銅/低介電常數器件—鍵合與封裝、引線鍵合工藝建模與模擬。
本書適合從事微電子晶片封裝科技以及專業從事引線鍵合科技研究的工程師、科研人員和科技人員閱讀,也可作為高等院校微電子封裝工程專業的高年級大學生、研究生和教師的教材和參考書。
作者簡介
喬治·哈曼(George Harman)是美國國家標準和技術研究所(NIST)一名退休研究員,於美國維吉尼亞理工學院取得物理學學士學位,於美國馬里蘭大學取得物理學碩士學位(1959)。 哈曼是國際微電子組裝與封裝協會(IMAPS)的前任主席(1995—1996)和美國電力電子工程師學會組件封裝與製造技術學會(IEEECPMT)委員會前任主席(1988—2002),並且作為國際電晶體科技發展路線圖(ITRS)的組裝和封裝委員會的成員超過10年。
哈曼被廣泛認為是世界上引線鍵合方面的權威人士,他發表了60多篇論文,出版了3本關於引線鍵合的書籍,擁有4項專利,30年間在世界各地開設了大約1000學時關於引線鍵合的短期課程。 哈曼在美國國內和國際上都獲得了許多獎項,截至本書英文版出版時,*近的獲獎是IMAPS“終身成就獎”(2006)和IEEE“元器件、封裝和製造技術現場獎”(2009)。
目錄
譯者序
原書前言
作者簡介
第1章科技概論1
1.1楔形和球形鍵合機操作2
1.2如何解决鍵合問題5
1.2.1哪些資料可以進行超聲鍵合5
1.2.2新鍵合系統的可鍵合性和可靠性7
1.2.3引線鍵合的特殊用途9
參考文獻9
第2章超聲鍵合系統與科技10
2.1引言10
2.2超聲換能器及鍵合工具的振動模式10
2.3超聲鍵合的形成(經驗描述)16
2.3.1超聲與熱超聲鍵合過程簡述20
2.4高頻超聲能量鍵合23
2.5鍵合過程(實时)監控25
2.6引線鍵合科技26
2.6.1熱壓鍵合26
2.6.2超聲楔形鍵合27
2.6.3熱超聲球形鍵合與楔形鍵合28
2.6.4新型/不同的引線鍵合科技28
2.7細引線鍵合科技的演變30
2.7.1薄帶線鍵合30
2.7.2平行間隙電極焊和鑷子焊接32
2.8引線鍵合的替代科技(倒裝晶片和載帶自動鍵合)33
2.8.1倒裝晶片33
2.8.2載帶自動鍵合34
2.9引線鍵合科技:比較和未來方向35
參考文獻37
第3章鍵合引線的冶金學特性41
3.1引言41
3.2鍵合引線的應力-應變特性41
3.3鍵合引線的存儲壽命老化42
3.4鍵合金絲的綜述47
3.5超聲楔形鍵合用鋁絲49
3.6引線及金屬層硬度50
3.7 EFO極性的影響50
3.8鍵合引線的疲勞效能51
3.9球形鍵合用的銅絲54
3.10導線燒斷(熔斷)55
3.10.1鍵合引線55
3.10.2印製電路板(PCB)及多晶片模組(MCM)導電線路的最大允許
電流59
附錄3A鍵合引線、鍵合試驗的ASTM標準和規範清單59
附錄3B銅絲鍵合是金絲鍵合的低成本解決方案嗎59
參考文獻62
第4章引線鍵合測試64
4.1引言64
4.2破壞性鍵合拉力測試65
4.2.1鍵合拉力測試的變數65
4.2.2剝離測試(鑷子拉拔)68
4.2.3失效預測—基於拉力測試數據69
4.2.4引線效能和鍵合工藝對拉力的影響69
4.2.5引線伸長對拉力的影響72
4.3焊球-剪切測試75
4.3.1引言75
4.3.2測試儀器75
4.3.3手動剪切探頭77
4.3.4焊球-剪切測試的影響因素78
4.3.5焊球剪切力與鍵合區域的關係82
4.3.6金-鋁金屬間化合物對剪切力的影響86
4.3.7拉拔測試、撬杠測試、翻轉測試及其他測試87
4.3.8焊球-剪切測試與鍵合點拉力測試的對比88
4.3.9焊球-剪切測試的應用88
4.3.10楔形鍵合點的剪切測試91
4.3.11焊球-剪切測試標準93
4.4球形和楔形鍵合點評估94
4.5熱應力試驗可靠性評估94
4.6未來面臨的問題95
附錄4A焊球-剪切測試的典型失效模式96
附錄4B非破壞性鍵合拉力測試97
4B. 1引言97
4B. 2 NDPT的冶金學和統計學解釋98
4B. 3由NDPT引起的冶金效能缺陷99
4B. 4 NDPT的局限性100
4B. 5關鍵航太應用中NDPT的現狀101
參考文獻102
第5章金-鋁金屬間化合物及其他金屬介面反應105
5.1金-鋁金屬間化合物的形成及經典的引線鍵合失效105
5.1.1概述105
5.1.2金-鋁體系中金屬間化合物的形成106
5.1.3經典金-鋁化合物失效模式111
5.1.4資料轉換的金-鋁介面116
5.1.5擴散抑制劑和阻擋層的作用117
5.2雜質加速金-鋁鍵合失效118
5.2.1鹵素的影響119
5.2.2去除或避免鹵素污染的建議122
5.2.3環氧樹脂非鹵素氣體排出導致的鍵合失效122
5.2.4綠色環保模塑膠123
5.3非金-鋁鍵合介面123
5.3.1鋁-銅引線鍵合123
5.3.2含銅的鋁鍵合焊盤125
5.3.3銅-金引線鍵合系統126
5.3.4鈀-金和鈀-鋁引線鍵合系統127
5.3.5銀-鋁引線鍵合系統129
5.3.6鋁-鎳引線鍵合系統130
5.3.7金-金、鋁-鋁、金-銀,以及某些不常用的單金屬鍵合系統131
附錄5A焊接不良的金-鋁引線鍵合的快速失效134
附錄5B金-鋁球形鍵合的熱退化136
附錄5C鍵合相關的腐蝕反應139
參考文獻141
第6章鍵合焊盤鍍層科技及可靠性147
6-A鍍金層雜質和狀態導致的鍵合失效147
6-A. 1鍍金層147
6-A. 2特定的電鍍雜質149
6-A. 3鍍膜層中氫氣滲入151
6-A.3.1電阻漂移151
6-A. 4金膜層內部/表面金屬雜質引發的失效152
6-A.4.1概述152
6-A.4.2鎳153
6-A.4.3銅154
6-A.4.4鉻155
6-A.4.5鈦155
6-A.4.6錫155
6-A. 5鍍金層標準156
6-A.5.1關於可靠鍍金層的建議156
6-A. 6自催化化學鍍金157
6-A. 7非金鍍層157
參考文獻158
6-B鎳基鍍層160
6-B. 1背景介紹160
6-B. 2化學鍍工藝161
6-B.2.1鍍鎳工藝163
6-B.2.2鍍鈀工藝164
6-B.2.3鍍金工藝164
6-B. 3鍵合焊盤鍍層—引線鍵合工藝視窗與可靠性166
6-B.3.1鎳/金層166
6-B.3.2鎳/鈀/金層169
6-B.3.3鎳/鈀層172
6-B. 4电浆清洗175
6-B. 5可直接鍵合的銅層176
參考文獻177
第7章清洗179
7.1引言179
7.1.1分子級清洗方法181
7.1.2紫外線-臭氧清洗182
7.1.3电浆清洗185
7.1.4电浆清洗機理187
7.1.5分子級和溶劑清洗方法評估188
7.1.6分子級清洗方法的問題190
7.1.7拋光191
7.2不同鍵合科技對表面污染的敏感性192
附錄7A电浆清洗造成的電路損傷194
參考文獻195
第8章引線鍵合中的力學問題198
8.1彈坑198
8.1.1引言198
8.1.2鍵合設備特徵及參數設置202
8.1.3鍵合力203
8.1.4鍵合工具引線-焊盤衝擊力204
8.1.5彈坑的成因—資料205
8.1.6金屬間化合物對彈坑的影響207
8.1.7矽結節引發的彈坑209
8.1.8多晶矽形成的彈坑211
8.1.9砷化鎵彈坑211
8.1.10彈坑問題小結214
8.2超聲楔形鍵合點的跟部裂紋214
8.3加速度、振動和衝擊對空腔封裝的影響216
8.3.1引線鍵合可靠性的離心試驗216
8.3.2超聲清洗、運載火箭熱衝擊、振動等對空腔封裝引線鍵合的
影響218
8.3.3衝擊和振動對引線鍵合的影響(長引線的問題)220
8.4功率和溫度迴圈對引線鍵合的影響221
附錄8A斷裂韌度225
附錄8B引線鍵合機參數的實驗設計(DOE)225
參考文獻229
第9章先進引線鍵合科技233
9.1高良率、更細節距引線鍵合和特定線弧的科技及問題233
9.1.1現代高良率引線鍵合科技介紹233
9.1.2高良率鍵合的要求(金屬層表面、硬度、清潔度)234
9.1.3鍵合設備及其管控237
9.1.4少數鍵合的可靠性(小樣本量統計)238
9.1.5封裝相關的鍵合良率問題239
9.1.6潜在的良率問題和解決方案239
9.1.7其他影響器件良率的因素241
9.1.8線弧241
9.1.9細節距球形和楔形鍵合243
9.1.10細節距鍵合的可靠性和測試問題246
9.1.11高良率和細節距鍵合的結論248
9.2 PCB、撓性板、BGA、MCM、SIP、軟基材器件和高性能系統中的
引線鍵合249
9.2.1引言249
9.2.2薄膜介質基板的鍵合249
9.2.3層壓基板的鍵合251
9.2.4增層253
9.2.5聚合物基板的資料效能對引線鍵合的影響254
9.2.6高性能系統封裝中引線鍵合的其他注意事項257
9.2.7典型封裝/板中導體金屬結構的趨膚效應258
9.2.8小結259
9.3極端溫度/環境中的引線鍵合259
9.3.1引言259
9.3.2高溫環境互連要求260
9.3.3低溫環境互連要求262
9.3.4極端溫度下的封裝效應262
9.3.5小結263
附錄9A引線鍵合機拱弧263
9A. 1引言263
9A. 2機器的運動和軌跡264
9A. 3線弧形狀264
9A. 4預彎曲265
9A. 5 CSP和BGA線弧266
9A. 6堆疊晶片和多晶片封裝266
9A. 7瓷嘴形成低線弧267
9A. 8瓷嘴形狀及其對拖拽/摩擦的影響267
9A. 9引線的作用268
9A. 10球形凸點和釘頭凸點269
9A. 11剛度-楊氏模量271
參考文獻271
第10章銅/低介電常數(Cu / Lo-k)器件—鍵合和封裝274
10.1引言274
10.2 Cu/Lo-k科技275
10.2.1 Lo-k電介質277
10.2.2銅鍵合焊盤的表面保護層和可鍵合性鍍層278
10.3集成電路Lo-k資料上銅焊盤的引線鍵合281
10.3.1 Lo-k倒裝晶片損傷284
10.4結論284
參考文獻285
第11章引線鍵合工藝建模與模擬287
11.1引言287
11.2假設、資料效能和分析方法288
11.3不同參數的引線鍵合工藝289
11.3.1超聲振幅的影響291
11.3.2超聲頻率的影響293
11.3.3摩擦係數的影響296
11.3.4鍵合焊盤厚度的影響298
11.3.5焊盤結構的影響301
11.3.6鍵合後襯底冷卻溫度建模304
11.3.7小結305
11.4有源區上方鍵合焊盤的引線鍵合與晶圓探針測試的影響
比較306
11.4.1探針測試模型306
11.4.2探針測試建模308
11.4.3探針測試與引線鍵合建模309
11.4.4小結310
11.5層壓基板上的引線鍵合310
11.5.1問題定義和資料内容311
11.5.2模型模擬結果與討論312
11.5.3實驗結果317
11.5.4小結318
參考文獻319
書摘插畫











-------------------------------------------------------------------------------------

【集成電路高可靠封裝技術】
編輯推薦
適讀人群:電子封裝工藝、科技和工程領域科研人員、高校師生及企業等相關組織科技工作者
作者團隊長期從事封裝工藝科技研究、集成電路可靠性研究、失效分析、封裝抗輻射加固科技研究和製造等工作。
對於高可靠集成電路,本書的內容既關注封測各工藝環節和檢測科技的新近成果,又關注科技落地實踐的經驗總結,對國內相關研究有一定的參攷價值。 也希望本書可以助力我國晶片產業進一步發展和逐步成熟。
內容簡介
本書應用理論和實際經驗並重,共分為五章。 第1章概括介紹了集成電路高可靠封裝體系框架; 之後四章詳細講解了劃片、粘片、引線鍵合和密封四大工序,每章都介紹相應工序的基本概念,並將該工序的重點內容、行業內關注的熱點、常見的失效問題及產生機理,按照小節逐一展開。 本書內容齊全,凝聚了多年的科研成果,更吸收了國內外相關科研工作者的智慧結晶,是現時關於集成電路高可靠封裝技術前沿、詳盡、實用的圖書。
本書可作為電子封裝工藝、科技和工程領域科研人員、高校師生及企業等相關組織科技工作者的重要參考書。
作者簡介
主編趙鶴然,在電子封裝領域工作十餘年; 長期從事封裝工藝科技研究、集成電路可靠性研究、失效分析、封裝抗輻射加固科技研究等工作; 作為專案負責人,主持項目兩項; 作為封裝負責人,參與科研、生產項目10餘項; 被中國電子科技集團公司第四十七研究所評為2019年度優秀青年人才,2020年度優秀科技人才。
目錄
前言
第1章概述1
1.1關鍵術語及含義1
1.1.1可靠性1
1.1.2高可靠2
1.1.3陶瓷封裝2
1.1.4潔淨室2
1.1.5質量等級3
1.1.6輻照加固保證(RHA)3
1.1.7二次篩選3
1.1.8失效分析(FA)3
1.1.9破壞性物理分析(DPA)5
1.1.10品質體系6
1.1.11統計程序控制(SPC)6
1.2電子封裝技術的發展6
1.2.1摩爾定律6
1.2.2集成電路和混合電路8
1.2.3高可靠封裝類型8
1.2.4金屬封裝類型10
1.2.5封裝外形圖及標注11
1.3封裝工藝及檢驗12
1.3.1高可靠封裝12
1.3.2檢驗12
1.3.3執行標準13
1.3.4美國標準14
參考文獻15
第2章劃片16
2.1劃片工藝概述16
2.1.1劃片工藝介紹16
2.1.2劃片管道17
2.1.3劃片工藝步驟19
2.1.4機遇與挑戰22
2.2劃片刀及原理23
2.2.1劃片刀組成23
2.2.2劃片刀結構特點23
2.2.3劃片刀切割機理25
2.2.4刀刃與線寬26
2.2.5刀片磨損26
2.3崩邊、分層及影響因素28
2.3.1正面崩邊28
2.3.2背面崩邊30
2.3.3劃片刀選型32
2.3.4砂輪轉速32
2.3.5藍膜粘接强度32
2.3.6晶圓厚度33
2.3.7冷卻水添加劑33
2.3.8劃片參數34
2.4鐳射切割34
2.4.1鐳射切割的優勢34
2.4.2紫外雷射劃片35
2.4.3雷射隱形劃片37
2.4.4微水刀雷射38
2.5劃片工藝面對的挑戰38
2.5.1超薄晶圓38
2.5.2低k介質晶圓39
2.5.3砷化鎵40
2.5.4碳化矽42
參考文獻43
第3章粘片45
3.1粘片工藝概述45
3.1.1粘片工藝介紹45
3.1.2粘片工藝的選擇46
3.1.3粘片品質標準———剪切强度46
3.1.4粘片品質指標———空洞率47
3.2導熱膠粘片47
3.2.1粘接原理47
3.2.2導電膠的固化48
3.2.3玻璃化轉變溫度Tg 48
3.3導電膠的特性49
3.3.1導電膠的組成49
3.3.2導電膠的導電原理49
3.3.3各向異性導電膠49
3.3.4導電性與粘接强度50
3.3.5水汽與導電性51
3.3.6固化溫度與導電性51
3.3.7銀遷移53
3.4粘接可靠性的失效模式與影響分析(FMEA)53
3.4.1 FMEA 53
3.4.2晶片粘接失效模式統計54
3.4.3晶片粘接FMEA表格的建立55
3.5導熱膠的失效56
3.5.1吸濕與氧化腐蝕56
3.5.2裂紋和分層56
3.5.3蠕變57
3.5.4溢出膠量與應力57
3.5.5膠層厚度與應力58
3.5.6不良應力與導熱膠粘接失效59
3.5.7保存與使用失效59
3.6晶片的堆疊與應力60
3.6.1多晶片堆疊60
3.6.2多層晶片堆疊應力集中61
3.6.3晶片的裂紋62
3.6.4爬膠與膠膜62
3.7焊接的基本概念63
3.7.1潤濕63
3.7.2鋪展64
3.7.3填縫65
3.7.4釺焊65
3.7.5軟焊料66
3.7.6介面金屬間化合物(IMC)66
3.7.7共晶66
3.7.8固溶體67
3.7.9相圖68
3.8晶片焊接工藝68
3.8.1晶片焊接68
3.8.2共晶摩擦粘片68
3.8.3燒結粘片68
3.8.4多溫度梯度粘片68
3.9典型焊料相圖與性質70
3.9.1 Sn-Pb合金70
3.9.2 Au-Sn合金71
3.9.3 Au-Si合金72
3.9.4 Au-Ge合金73
3.10真空燒結粘片73
3.10.1真空燒結的含義73
3.10.2燒結溫度曲線74
3.10.3焊料熔融時間75
3.10.4燒結過程中的氣氛76
3.10.5燒結過程中的還原氣體78
3.10.6燒結過程中的焊接壓力79
3.11晶片焊接失效模式81
3.11.1失效模式分析81
3.11.2晶片脫落失效原因及採取措施82
3.11.3粘接空洞失效原因及採取措施82
3.11.4內部氣氛不合格原因及採取措施83
3.12焊接空洞83
3.12.1焊接空洞的標準83
3.12.2氧化對空洞的影響84
3.12.3助焊劑選型與空洞84
3.12.4焊接工藝與空洞率84
3.12.5真空度與焊接空洞85
參考文獻86
書摘插畫



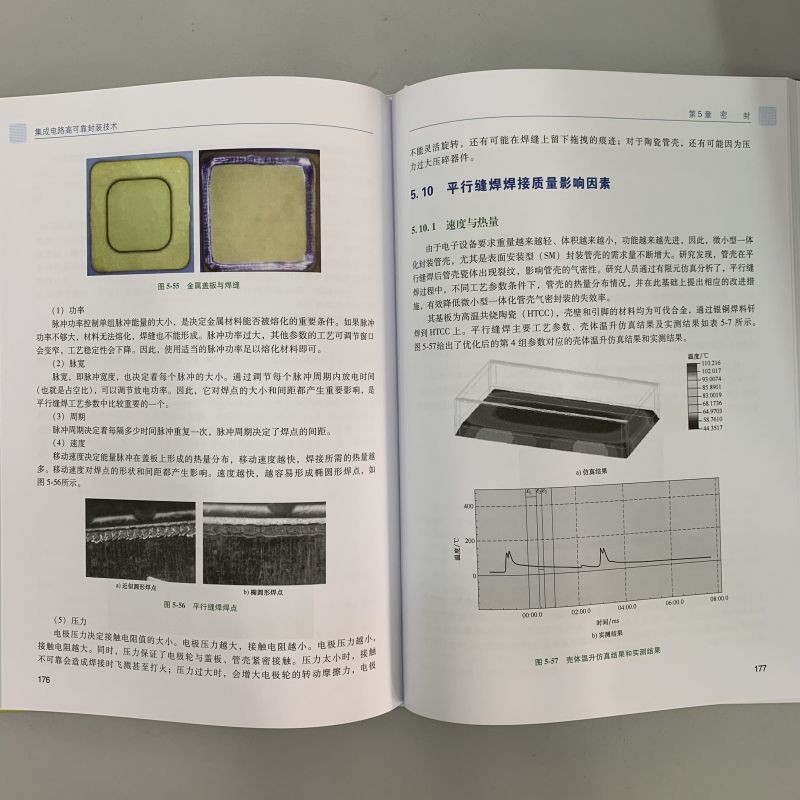
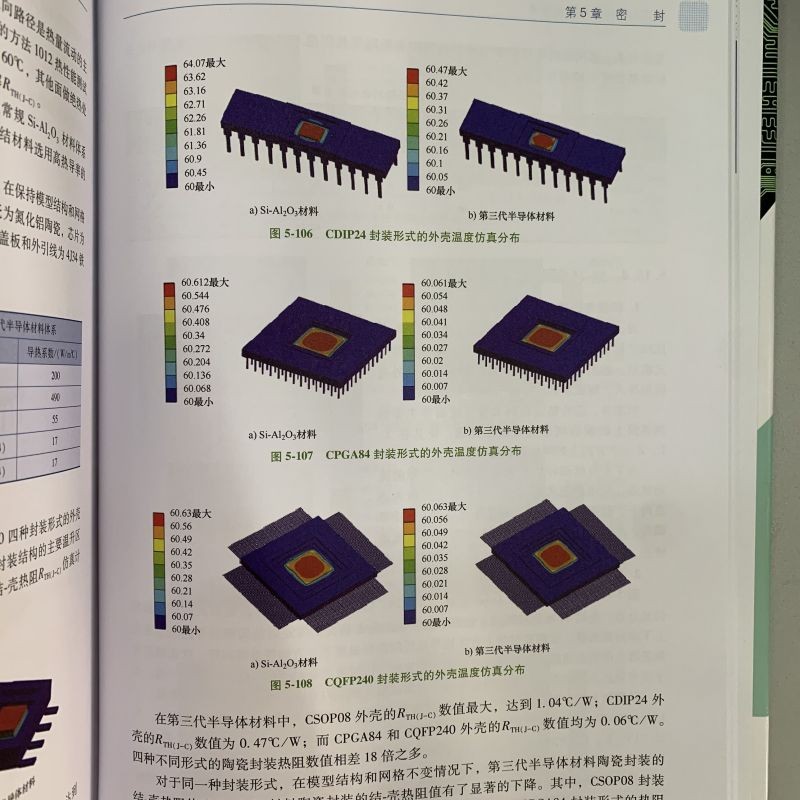






-------------------------------------------------------------------------------------

【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】
內容簡介
傳統軟釺料合金在微電子工業中已得到了廣泛的應用,然而軟釺料合金已經不能滿足第三代寬禁帶電晶體(碳化矽和氮化鎵)器件的高溫應用需求。 新型銀燒結/銅燒結科技和瞬態液相鍵合科技是實現高溫器件可靠連接的關鍵技術,該科技對新能源電動汽車、軌道交通、光伏、風電以及國防等領域具有重要意義。 本書較為全面地介紹了當前用於高溫環境下的晶片連接所涉及的新型互連資料的理論基礎、工藝方法、失效機制、工藝設備、品質控制與可靠性。
本書可作為功率電子領域資料、工藝和可靠性工程師的參考書,也可作為高校相關專業的教材。
目錄
譯者序
原書序
原書前言
譯者簡介
第1章銀燒結科技和傳統回流科技:連接工藝及其差异
1.1引言
1.2軟釺焊科技
1.2.1焊料熔點
1.2.2介面反應
1.2.3凝固
1.2.4微觀結構分析
1.3銀燒結科技
1.3.1燒結驅動力
1.3.2銀燒結的過程
1.3.3銀互擴散層的形成
1.3.4老化過程中的微觀結構演變
1.4銀燒結與常用軟釺焊資料的性能比較
1.5燒結銀的孔隙率
1.5.1孔洞和氣孔的定義說明
1.5.2孔洞的形成及影響因素
1.5.3孔隙率測定
1.5.4孔隙率對機械效能的影響
1.5.5孔隙率對熱導率的影響
1.5.6孔隙率對電導率的影響
1.6總結與結論
參考文獻
第2章燒結銀資料在LED領域的應用
2.1 LED晶片的連接應用簡介
2.1.1 LED介紹
2.1.2常見的?? LED晶片結構
2.1.3用於?? LED晶片連接的晶片貼裝科技平臺
2.1.4 LED連接資料的選擇
2.1.5結論??
2.2大功率LED應用的燒結銀漿
2.2.1用於?? LED的燒結銀漿介紹
2.2.2燒結銀:分類、工藝條件及比較
2.2.3燒結銀漿的可靠性問題
2.2.4結論
2.3銀-銀直接鍵合及其在LED晶片連接中的應用
2.3.1銀-銀直接鍵合的基礎介紹
2.3.2氧在銀-銀直接鍵合中的作用
2.3.3殘餘應力在銀-銀直接鍵合中的作用
2.3.4納米銀小丘機制
2.3.5結論??
參考文獻
第3章燒結銀焊點工藝控制
3.1引言:利用燒結銀作為晶片連接資料
3.2選擇燒結銀的因素
3.3壓力燒結與無壓燒結的燒結銀焊點比較
3.4銀燒結中的關鍵步驟
3.4.1基板或晶圓印刷??
3.4.2預熱
3.4.3壓力燒結設備
3.4.4晶片塑封-貼片-壓力燒結
3.5大規模生產中銀燒結的工藝控制
3.5.1燒結銀焊點的鍵合線厚度、孔隙率和圓角高度的控制??
3.5.2銀燒結的模具設備控制??: 晶片的貼片、旋轉和傾斜
3.5.3確保晶片粘接强度
3.5.4電力和可靠性測試
3.6燒結銀焊點的失效分析科技
3.6.1差示掃描量熱??- 熱重分析儀(DSC-TGA)
3.6.2熱機械分析儀(TMA)
3.6.3掃描電子顯微鏡??- 能譜儀(SEM-EDS)
3.6.4透射電子顯微鏡(TEM)
3.6.5飛行時間二次離子質譜儀(TOF-SIMS)
3.6.6軟件建模與模擬??
3.6.7熱成像
3.6.8 X射線成像
3.6.9 C -掃描聲學顯微鏡(C-SAM)
3.7結論和展望
參考文獻
第4章高溫連接介面資料的熱機械可靠性建模
4.1引言
4.2熱機械建模
4.2.1資料内容
4.2.2模型設定
4.2.3求解
4.2.4應變能密度模擬結果
4.3熱機械建模中的斷裂力學方法
4.3.1迴圈加載的彈塑性斷裂力學
4.3.2 ANSYS中?? J積分的計算
4.3.3其他斷裂力學參數
4.4關於燒結銀的簡要說明
4.5結論
參考文獻
第5章燒結銀焊點的可靠性和失效機制
5.1引言
5.2機械效能
5.2.1彈性模量??
5.2.2强度
5.2.3蠕變
5.2.4疲勞和棘輪效應
5.3燒結銀焊點的可靠性評估
5.3.1熱老化
5.3.2熱迴圈
5.3.3功率迴圈
5.3.4燒結銀的電化學遷移
5.4結論與展望
參考文獻
第6章原子遷移誘發的燒結銀形態變化
6.1引言
6.2熱老化下的微觀結構演化
6.2.1熱老化下微觀結構的粗化
6.2.2金屬接觸的擴散現象
6.3燒結銀中的電遷移
6.4結論
參考文獻
第7章同等原則與作為晶片連接資料的燒結銀膏
7.1引言
7.2同等原則的主要案例與準則
7.3燒結銀科技背景
7.4燒結銀膏的專利侵權分析
7.5侵權測試與方法論
7.6案例1:納米銀膏vs微米銀膏
7.7案例2:納米銀膏vs納米銀膏
7.8結論
參考文獻
第8章銅燒結科技:工藝與可靠性
8.1功率半導體器件燒結科技簡介
8.2銅納米粒子的製備
8.3熱效能
8.3.1熱阻的量測和熱導率的估算
8.3.2進一步類比
8.4可靠性
8.4.1功率迴圈測試
8.4.2熱迴圈測試
8.5結論
參考文獻
第9章瞬態液相鍵合科技
9.1引言:無鉛耐高溫連接科技挑戰
9.2瞬態液相鍵合:熱力學的關鍵概念
9.2.1銅??- 錫二元系統:反應、金屬間化合物的形成及相互擴散
9.2.2銅??- 鎳二元系統:單一擴散
9.2.3三元系統中沉澱物的析出
9.3瞬態液相鍵合:動力學的關鍵概念
9.3.1金屬間化合物的增長率
9.3.2反應幾何形狀對等溫凝固速率的影響:改變反應的低溫相體積和介面面積
9.4製造和設計約束
9.5潤濕和微觀結構的不均勻
9.5.1不完全潤濕
9.5.2瞬態液相燒結系統中液體的再分佈和多孔隙的形成
9.5.3等溫凝固和固態轉變過程中孔隙的形成
9.6商業電子產品的應用和科技要求
9.6.1應用溫度
9.6.2應用需求
9.7瞬態液相鍵合設計的一般熱力學框架
9.7.1二元瞬態液相鍵合系統
9.7.2三元體系
9.8與競爭科技的比較
9.8.1焊料
9.8.2燒結銀
9.8.3導電膠
9.8.4與瞬態液相鍵合的力學性能比較
9.9瞬態液相鍵合的工藝設計
9.9.1流程優化
9.9.2新工藝和幾何結構
9.10結論
參考文獻
第10章惡劣環境下的晶片連接資料
10.1引言
10.2連接焊料
書摘插畫








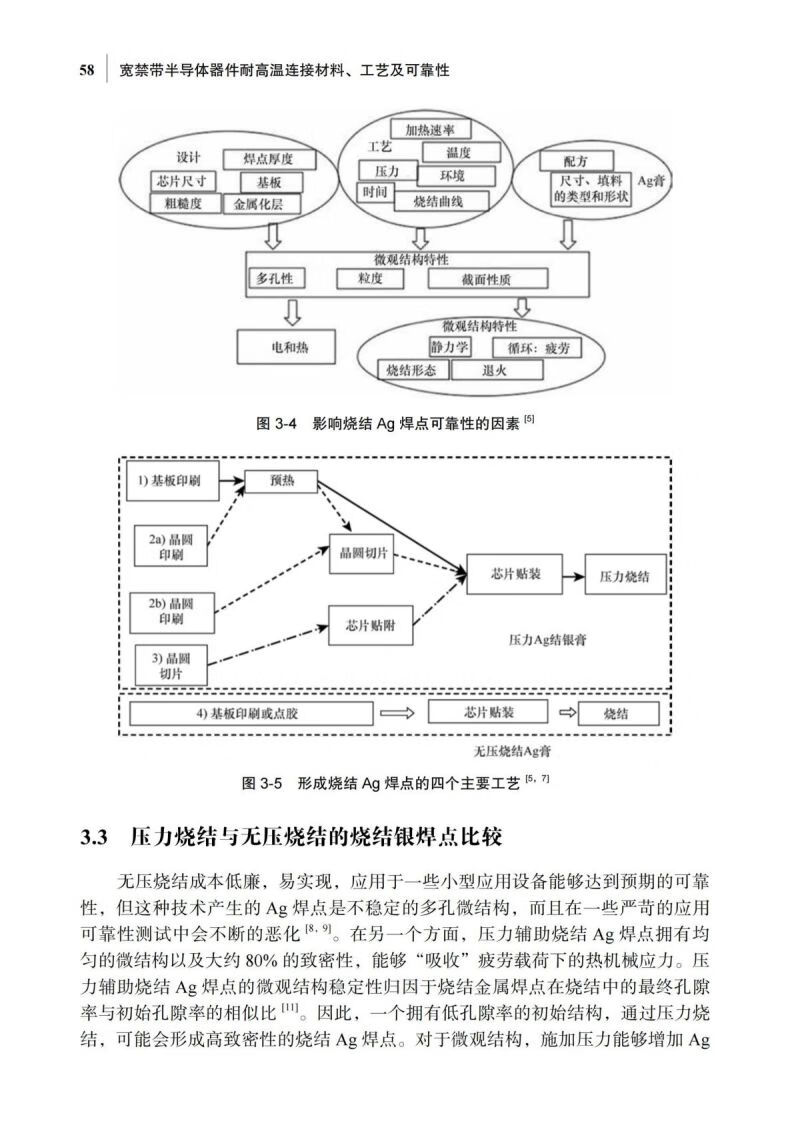



高雄方**[0920***832] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 基隆鄭**[0988***456] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 新北柳**[0933***185] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北李**[0920***334] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 基隆孫**[0946***515] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 桃園李**[0932***853] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北孫**[0932***138] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【任選兩册,備註書號】 臺北錢**[0956***348] 4分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【任選兩册,備註書號】 高雄趙**[0966***988] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 桃園符**[0966***841] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北鄭**[0956***710] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 新竹仲**[0920***273] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 新北謝**[0968***418] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 臺北符**[0988***966] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 新竹孫**[0918***160] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 臺南鄭**[0960***388] 25分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【任選兩册,備註書號】 臺中仲**[0986***127] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【任選兩册,備註書號】 臺中黃**[0938***355] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 新竹趙**[0986***494] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 桃園李**[0986***651] 半小時前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 臺中謝**[0998***312] 4分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 嘉義楊**[0968***721] 4分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北鍾**[0951***771] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北仲**[0920***256] 20分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 基隆張**[0918***575] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 嘉義張**[0998***453] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 嘉義謝**[0966***749] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 新北王**[0933***425] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 桃園楊**[0966***284] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 新北仲**[0978***396] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 臺南王**[0988***881] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 臺中朱**[0938***896] 半小時前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 新北趙**[0978***994] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 臺南柳**[0951***989] 半小時前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 嘉義吳**[0920***436] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 基隆鍾**[0986***932] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 桃園鍾**[0918***428] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 臺中柳**[0956***109] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 臺中趙**[0988***163] 12分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 嘉義朱**[0956***636] 20分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 嘉義朱**[0932***601] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【任選兩册,備註書號】 桃園吳**[0933***356] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 新竹鄭**[0918***707] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 高雄謝**[0978***211] 2分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ①【集成電路高可靠封裝技術】(單册) 高雄周**[0920***790] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册) 臺北謝**[0951***535] 7分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 臺中謝**[0933***794] 5分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - 【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(精裝塑封三册) 高雄吳**[0978***256] 11分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 新竹王**[0960***896] 25分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ②【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】(單册) 臺南錢**[0968***861] 20分鐘前【集成電路高可靠封裝技術】+【微電子引線鍵合】+【寬禁帶半導體器件耐高溫連接資料、工藝及可靠性】 - ③【微電子引線鍵合】(單册)
































